-
 MDPpro 850+少子壽命測試儀用于單晶硅錠、硅磚和硅晶圓片的生產和質量監控。用于HJT、HIT、TOPcon、雙面PERC、PERC+太陽能電池、鈣鈦礦等中的硅材料。特征直拉硅單晶硅錠中的滑移線壽命范圍20ns至100ms(樣品電阻率>0.3Ohmcm)SEMI標準PV9-1110測試速度線掃描<30s完整的面掃秒<5min同時測量壽命μPCD/MDP(QSS)和電阻率直拉硅單晶硅錠中的滑移線自動幾
MDPpro 850+少子壽命測試儀用于單晶硅錠、硅磚和硅晶圓片的生產和質量監控。用于HJT、HIT、TOPcon、雙面PERC、PERC+太陽能電池、鈣鈦礦等中的硅材料。特征直拉硅單晶硅錠中的滑移線壽命范圍20ns至100ms(樣品電阻率>0.3Ohmcm)SEMI標準PV9-1110測試速度線掃描<30s完整的面掃秒<5min同時測量壽命μPCD/MDP(QSS)和電阻率直拉硅單晶硅錠中的滑移線自動幾 -
 RESmap電阻率測試儀特征電阻率的非接觸式測量和成像高頻渦流傳感原理與集成紅外溫度傳感器可校正樣品的溫度變化信號靈敏度基于線圈頻率讀數(正在申請專利)的高信號靈敏度,可實現準確可靠的電阻率測量,并具有高再現性和可重復性測量時間測量時間<3s,測量之間時間<1s測量速度200mm晶圓/晶錠<30s,9個點多點測量及測繪顯示最高9999個點材料外形尺寸平坦或略微彎曲的晶圓、晶錠、錠板、毛坯和薄膜X-Y
RESmap電阻率測試儀特征電阻率的非接觸式測量和成像高頻渦流傳感原理與集成紅外溫度傳感器可校正樣品的溫度變化信號靈敏度基于線圈頻率讀數(正在申請專利)的高信號靈敏度,可實現準確可靠的電阻率測量,并具有高再現性和可重復性測量時間測量時間<3s,測量之間時間<1s測量速度200mm晶圓/晶錠<30s,9個點多點測量及測繪顯示最高9999個點材料外形尺寸平坦或略微彎曲的晶圓、晶錠、錠板、毛坯和薄膜X-Y -
 MDpicts 微波探測光誘導電流瞬態譜儀MDpicts微波探測光誘導電流瞬態譜儀圖1.與溫度有關的載流子發射瞬態靈敏度:半導體材料電學缺陷分析的高靈敏度溫度范圍:液氮(77k)至500k。可選:液氦(4k)或更高溫度衰減常數范圍:20納秒到幾毫秒沾污檢測:電學陷阱基本性能確定:激活能和陷阱的俘獲截面,受溫度和注入水平影響的少子壽命參數等重復性:>99.5%,測量時間:<60分鐘。液氮消耗:2升/次靈活性:從365nm到1
MDpicts 微波探測光誘導電流瞬態譜儀MDpicts微波探測光誘導電流瞬態譜儀圖1.與溫度有關的載流子發射瞬態靈敏度:半導體材料電學缺陷分析的高靈敏度溫度范圍:液氮(77k)至500k。可選:液氦(4k)或更高溫度衰減常數范圍:20納秒到幾毫秒沾污檢測:電學陷阱基本性能確定:激活能和陷阱的俘獲截面,受溫度和注入水平影響的少子壽命參數等重復性:>99.5%,測量時間:<60分鐘。液氮消耗:2升/次靈活性:從365nm到1 -
 MDPmap 晶圓片壽命檢測儀特性靈敏度:對外延工藝監控和不可見缺陷檢測,具有可視化測試的高分辨率測量速度:6英寸硅晶圓片,1mm分辨率,小于5分鐘壽命測試范圍:20納秒到幾十毫秒沾污檢測:源自坩堝和生長設備的金屬(Fe)污染測量能力:從初始切割的晶圓片到所有工藝加工的樣品靈活性:允許外部激光通過觸發器,與探測模塊耦合可靠性:模塊化和緊湊臺式儀器,更高可靠性,正常運行時間>99%重現性:>99.5%電阻率:無需
MDPmap 晶圓片壽命檢測儀特性靈敏度:對外延工藝監控和不可見缺陷檢測,具有可視化測試的高分辨率測量速度:6英寸硅晶圓片,1mm分辨率,小于5分鐘壽命測試范圍:20納秒到幾十毫秒沾污檢測:源自坩堝和生長設備的金屬(Fe)污染測量能力:從初始切割的晶圓片到所有工藝加工的樣品靈活性:允許外部激光通過觸發器,與探測模塊耦合可靠性:模塊化和緊湊臺式儀器,更高可靠性,正常運行時間>99%重現性:>99.5%電阻率:無需 -
 MDPspot 單點壽命檢測儀桌面單點測量低成本的臺式少子壽命測量系統,對不同制備階段的硅材料電學參數進行表征。沒有內置自動化。可選配手動z軸,用于厚度在156毫米以下的晶錠。MDPspot可配電阻率測試選項。僅適用于硅,用于晶圓片,也可用于晶錠。結果可視化的標準軟件。特性無接觸和非破壞的電學參數測試對外延工藝監控和不可見缺陷檢測,具有高分辨的可視化測試對于不同級別晶圓片,提供不同的菜單選項優勢用于不同制備階段,從成體到最
MDPspot 單點壽命檢測儀桌面單點測量低成本的臺式少子壽命測量系統,對不同制備階段的硅材料電學參數進行表征。沒有內置自動化。可選配手動z軸,用于厚度在156毫米以下的晶錠。MDPspot可配電阻率測試選項。僅適用于硅,用于晶圓片,也可用于晶錠。結果可視化的標準軟件。特性無接觸和非破壞的電學參數測試對外延工藝監控和不可見缺陷檢測,具有高分辨的可視化測試對于不同級別晶圓片,提供不同的菜單選項優勢用于不同制備階段,從成體到最 -
 MDPinline ingot 晶錠在線面掃檢測儀MDPinlineingot系統是一種多晶硅晶錠電學參數特性測量工具。它是專為高通量工廠的單塊晶錠測試而研發的。每塊晶錠可以在不到一分鐘時間里測量其四面。所有的圖譜(壽命,光電導率,電阻率)都是同時測量的。該系統包括一個數據庫和統計數據評估,可用于自動確定精確的切割位置,以提高成品率。用于材料質量監控,爐選擇和工藝改進。性能無接觸破壞的半導體特性少數載流子壽命的檢測能力Automateddet
MDPinline ingot 晶錠在線面掃檢測儀MDPinlineingot系統是一種多晶硅晶錠電學參數特性測量工具。它是專為高通量工廠的單塊晶錠測試而研發的。每塊晶錠可以在不到一分鐘時間里測量其四面。所有的圖譜(壽命,光電導率,電阻率)都是同時測量的。該系統包括一個數據庫和統計數據評估,可用于自動確定精確的切割位置,以提高成品率。用于材料質量監控,爐選擇和工藝改進。性能無接觸破壞的半導體特性少數載流子壽命的檢測能力Automateddet -
 MDPinline 晶圓片在線面掃檢測儀MDPinline是一種用于快速定量測量載流子壽命并集成掃描功能的檢測儀。通過工廠安裝的傳送帶將晶圓片移至儀器,在不到一秒的時間內,就可以“動態”測量出晶圓圖。該儀器本身不使用機械運動部件,因此在連續操作下也非常可靠。它為每個晶圓片提供完整的拓撲結構,這為提高生產線的成本效益和效率提供了新的途徑。例如,在不到3個小時的時間內,對10000個晶圓片的拓撲結構進行自動統計評
MDPinline 晶圓片在線面掃檢測儀MDPinline是一種用于快速定量測量載流子壽命并集成掃描功能的檢測儀。通過工廠安裝的傳送帶將晶圓片移至儀器,在不到一秒的時間內,就可以“動態”測量出晶圓圖。該儀器本身不使用機械運動部件,因此在連續操作下也非常可靠。它為每個晶圓片提供完整的拓撲結構,這為提高生產線的成本效益和效率提供了新的途徑。例如,在不到3個小時的時間內,對10000個晶圓片的拓撲結構進行自動統計評 -
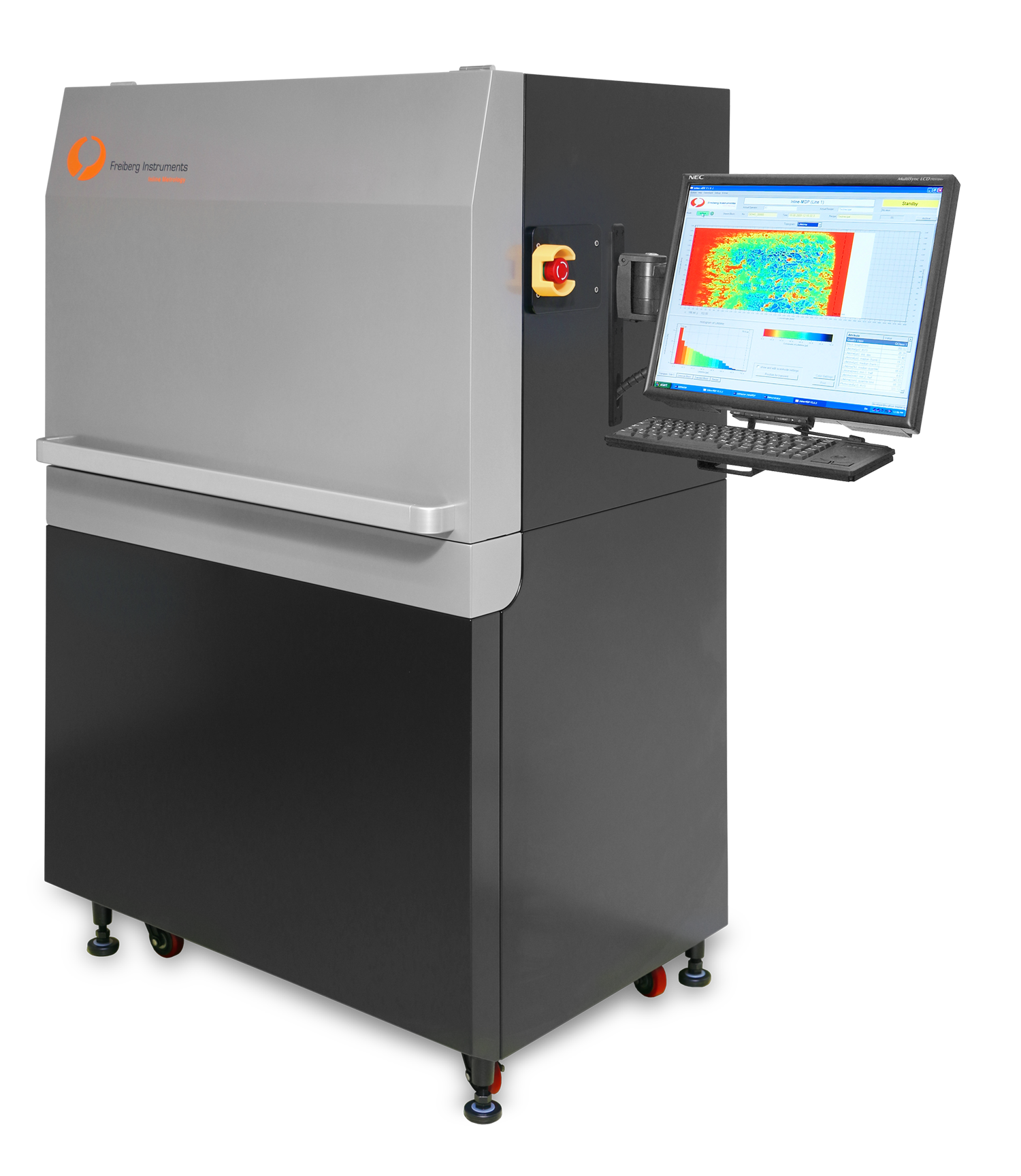 MDPpro 晶圓片/晶錠壽命檢測儀根據SEMI標準PV9-1110的非接觸式和無損成像(μPCD/MDP(QSS))、光電導性、電阻率和p/n檢查。晶圓切割,爐內監控,材料優化等。日常壽命測量,質量控制和檢驗產量:>240塊/天或>720片/天測量速度:對于156x156x400mm標準晶錠,<4分鐘良品率提升:1mm切割標準為156x156x400mm標準晶錠質量控制:用于過程和材料的質量監控,如單晶
MDPpro 晶圓片/晶錠壽命檢測儀根據SEMI標準PV9-1110的非接觸式和無損成像(μPCD/MDP(QSS))、光電導性、電阻率和p/n檢查。晶圓切割,爐內監控,材料優化等。日常壽命測量,質量控制和檢驗產量:>240塊/天或>720片/天測量速度:對于156x156x400mm標準晶錠,<4分鐘良品率提升:1mm切割標準為156x156x400mm標準晶錠質量控制:用于過程和材料的質量監控,如單晶

