-
 寬域變溫掃描MDP-PICTS技術革新半導體質控的三大核心突破在光伏與微電子產業高速發展的今天,半導體材料的質量控制已成為決定產品良率與成本的核心要素。傳統電學表征技術因需接觸式電極制備,存在破壞樣品、空間分辨率低、難以適應產線節奏等痛點。FreibergInstruments公司憑借其革命性的微波檢測技術——微波探測光導率(MDP)與微波探測光誘導電流瞬態譜(MDPICTS),正在全球半導體材料分析領域掀起技術革新浪潮。一、技術
寬域變溫掃描MDP-PICTS技術革新半導體質控的三大核心突破在光伏與微電子產業高速發展的今天,半導體材料的質量控制已成為決定產品良率與成本的核心要素。傳統電學表征技術因需接觸式電極制備,存在破壞樣品、空間分辨率低、難以適應產線節奏等痛點。FreibergInstruments公司憑借其革命性的微波檢測技術——微波探測光導率(MDP)與微波探測光誘導電流瞬態譜(MDPICTS),正在全球半導體材料分析領域掀起技術革新浪潮。一、技術 -
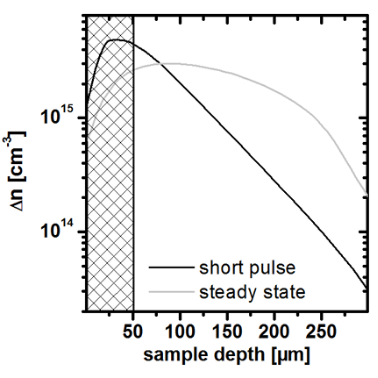 基于深度分辨光電導法的半導體缺陷檢測---Freiberg Instruments MDP技術隨著半導體器件結構向多層化、薄層化發展,傳統載流子壽命檢測技術已難以滿足精度需求。固定激發深度的測量方法無法區分表面重組效應與體材料/界面缺陷,導致工藝優化缺乏針對性指導。FreibergInstruments公司在相關期刊發表的突破性研究表明,其新型微波檢測光電導率系統(MDP)通過可編程脈沖激光激發與深度關聯算法,首次實現5-300μm范圍內缺陷分布的三維可視化(圖1)。圖1.厚度為
基于深度分辨光電導法的半導體缺陷檢測---Freiberg Instruments MDP技術隨著半導體器件結構向多層化、薄層化發展,傳統載流子壽命檢測技術已難以滿足精度需求。固定激發深度的測量方法無法區分表面重組效應與體材料/界面缺陷,導致工藝優化缺乏針對性指導。FreibergInstruments公司在相關期刊發表的突破性研究表明,其新型微波檢測光電導率系統(MDP)通過可編程脈沖激光激發與深度關聯算法,首次實現5-300μm范圍內缺陷分布的三維可視化(圖1)。圖1.厚度為 -
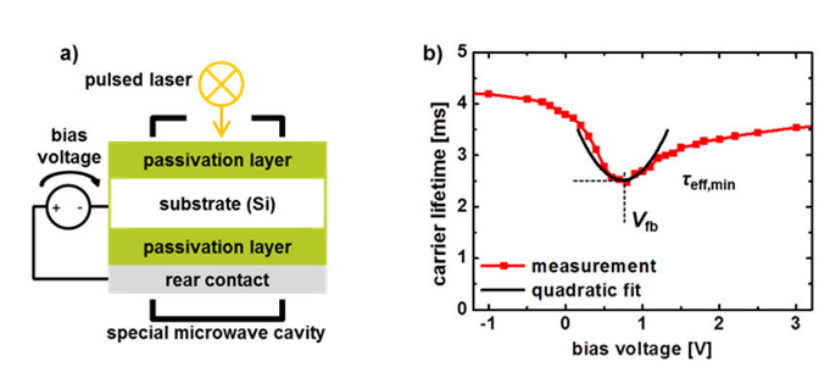 BiasMDP 技術搭配MDPmap設備---開啟表面鈍化檢測新方式在能源產業蓬勃發展的當下,追求更高效率的太陽能電池成為行業核心目標。而這其中,表面鈍化技術的優劣起著決定性作用。要深入理解和優化表面鈍化,精準測量固定電荷和界面缺陷密度這兩個關鍵參數至關重要。為大家介紹一項引領行業變革的創新技術——基于微波探測光電導衰減法(MDP)的BiasMDP技術,這一技術在實驗測量環節,FreibergInstruments公司的MDPmap型號
BiasMDP 技術搭配MDPmap設備---開啟表面鈍化檢測新方式在能源產業蓬勃發展的當下,追求更高效率的太陽能電池成為行業核心目標。而這其中,表面鈍化技術的優劣起著決定性作用。要深入理解和優化表面鈍化,精準測量固定電荷和界面缺陷密度這兩個關鍵參數至關重要。為大家介紹一項引領行業變革的創新技術——基于微波探測光電導衰減法(MDP)的BiasMDP技術,這一技術在實驗測量環節,FreibergInstruments公司的MDPmap型號 -
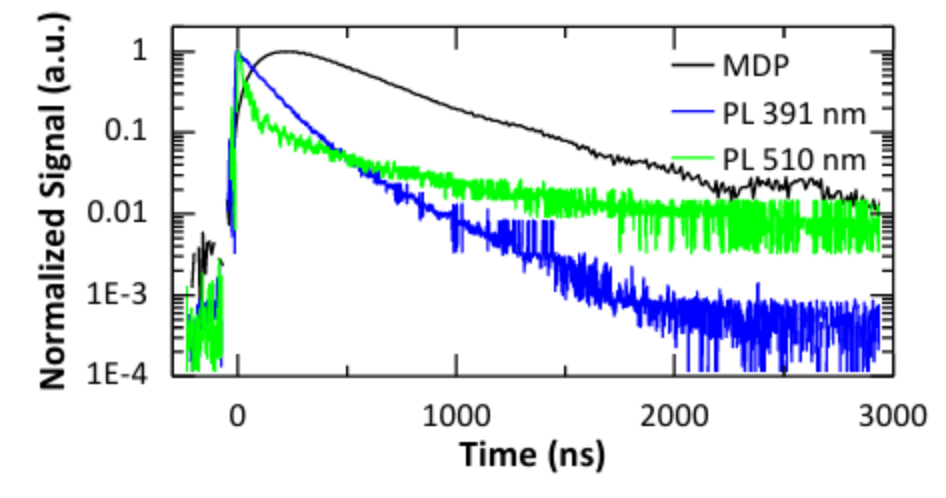 解鎖4H-SiC外延片潛力-MDP 技術的突破性應用在半導體器件性能參數中,少數載流子壽命占據核心地位,尤其在SiC應用于高壓器件時,其對整體性能起著決定性作用。通過控制載流子壽命,能顯著提升器件在不同場景下的表現。然而,4H-SiC外延層中,載流子壽命受多種復雜因素制約,外延層表面、與襯底的界面、外延層自身以及襯底都會影響載流子復合。同時,測量條件的差異,如激發波長和強度的變化,也會干擾有效載流子壽命的準確測定。這使得精準把握載流子壽命變得極
解鎖4H-SiC外延片潛力-MDP 技術的突破性應用在半導體器件性能參數中,少數載流子壽命占據核心地位,尤其在SiC應用于高壓器件時,其對整體性能起著決定性作用。通過控制載流子壽命,能顯著提升器件在不同場景下的表現。然而,4H-SiC外延層中,載流子壽命受多種復雜因素制約,外延層表面、與襯底的界面、外延層自身以及襯底都會影響載流子復合。同時,測量條件的差異,如激發波長和強度的變化,也會干擾有效載流子壽命的準確測定。這使得精準把握載流子壽命變得極 -
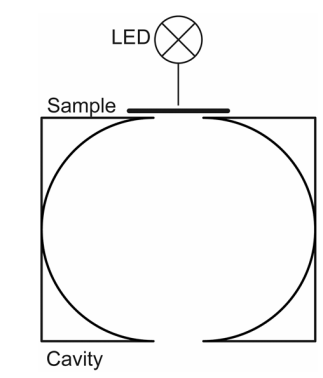 深能級缺陷表征-MDPICTS在半導體材料的研究與應用中,缺陷表征至關重要。特別是在中子嬗變摻雜(NTD)硅的處理過程中,了解其輻射誘導缺陷對于優化退火條件、提升材料性能意義非凡。FreibergInstruments公司的微波探測光致電流瞬態光譜法(MDPICTS)技術(如圖1),為這一領域帶來了新的突破,展現出諸多傳統技術難以企及的優點。NTD硅,因能實現極低的電阻率變化,在大面積輻射探測器制造中占據重要地位。然而,摻
深能級缺陷表征-MDPICTS在半導體材料的研究與應用中,缺陷表征至關重要。特別是在中子嬗變摻雜(NTD)硅的處理過程中,了解其輻射誘導缺陷對于優化退火條件、提升材料性能意義非凡。FreibergInstruments公司的微波探測光致電流瞬態光譜法(MDPICTS)技術(如圖1),為這一領域帶來了新的突破,展現出諸多傳統技術難以企及的優點。NTD硅,因能實現極低的電阻率變化,在大面積輻射探測器制造中占據重要地位。然而,摻 -
 少數載流子壽命測試儀測定硅片中的鐵濃度鐵含量的準確測定是非常重要的,因為鐵是硅中含量最豐富也是最有害的缺陷之一。因此,有必要盡可能準確和快速地測量鐵濃度,并具有非常高的分辨率,最好是在線測量。使用德國FreibergMDPingot和MDPmap系列,可以全自動測量晶錠和晶片中的鐵濃度,并具有高分辨率。鐵硼對解離前后的壽命測量是硅片鐵含量測定中廣泛應用的方法。在高摻雜濃度的硼摻雜硅中,當它用于光伏應用時,幾乎100%的電活性鐵以F
少數載流子壽命測試儀測定硅片中的鐵濃度鐵含量的準確測定是非常重要的,因為鐵是硅中含量最豐富也是最有害的缺陷之一。因此,有必要盡可能準確和快速地測量鐵濃度,并具有非常高的分辨率,最好是在線測量。使用德國FreibergMDPingot和MDPmap系列,可以全自動測量晶錠和晶片中的鐵濃度,并具有高分辨率。鐵硼對解離前后的壽命測量是硅片鐵含量測定中廣泛應用的方法。在高摻雜濃度的硼摻雜硅中,當它用于光伏應用時,幾乎100%的電活性鐵以F -
 德國Freiberg少子壽命測試儀微波檢測到的光電導率德國FreibergMDP非常適合以下兩種方法,一是通過測量取決于注入量的少數載流子壽命來進行缺陷調查,二是用于在線測量的晶圓甚至晶錠的圖形化。它在靈敏度、分辨率和速度方面超過了µPCD(微波檢測光導衰減)和QSSPC(準穩態光導)。利用矩形激光脈沖激發前后的微波吸收,測量了與擴散長度密切相關的光電導率。圖1顯示了德國FreibergMDP和MD-PICTS測量的測量原理。圖1.能
德國Freiberg少子壽命測試儀微波檢測到的光電導率德國FreibergMDP非常適合以下兩種方法,一是通過測量取決于注入量的少數載流子壽命來進行缺陷調查,二是用于在線測量的晶圓甚至晶錠的圖形化。它在靈敏度、分辨率和速度方面超過了µPCD(微波檢測光導衰減)和QSSPC(準穩態光導)。利用矩形激光脈沖激發前后的微波吸收,測量了與擴散長度密切相關的光電導率。圖1顯示了德國FreibergMDP和MD-PICTS測量的測量原理。圖1.能 -
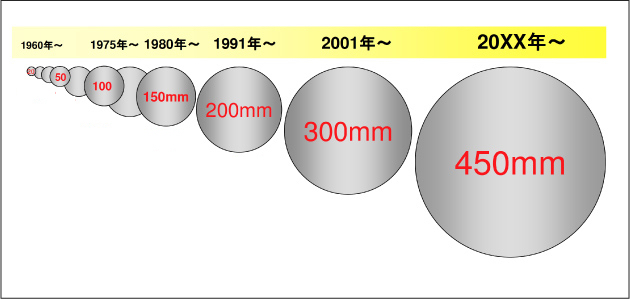 半導體18英寸晶圓片的少數載流子壽命圖幾年來,微電子行業正計劃將晶圓片直徑從300毫米(12英寸)擴大到450毫米(18英寸),以獲得更高的成品率。現在已經有了生產這種高質量晶圓片的技術,但只有調整晶圓廠的成本問題,仍然無法轉移到更大的晶圓尺寸。這些450毫米晶圓片還需要檢查外部和內部雜質,因此需要高度空間分辨壽命測量。在與FraunhoferIISB的合作中,FreibergInstruments在EC資助的SEA4KET項目中
半導體18英寸晶圓片的少數載流子壽命圖幾年來,微電子行業正計劃將晶圓片直徑從300毫米(12英寸)擴大到450毫米(18英寸),以獲得更高的成品率。現在已經有了生產這種高質量晶圓片的技術,但只有調整晶圓廠的成本問題,仍然無法轉移到更大的晶圓尺寸。這些450毫米晶圓片還需要檢查外部和內部雜質,因此需要高度空間分辨壽命測量。在與FraunhoferIISB的合作中,FreibergInstruments在EC資助的SEA4KET項目中

