半導體晶圓片和晶錠的電阻率測量
電阻率是材料最重要的電參數之一。它是半導體器件(如太陽能電池)性能的關鍵參數,并取決于材料的摻雜密度。因此,為了檢測摻雜密度的不均勻性,需要對電阻率進行高精度、高分辨率的測量。

使用德國freiberg MDPmap和MDPingot,可以通過渦流測量高精度和分辨率為1毫米的方式來測量晶圓片或晶塊的電阻率。由于距離相關的內部校準矩陣,渦流傳感器有一個非常好的長期穩定性。因此,每一個電阻率圖都是測量表面平坦度的幾何圖。電阻率可與少數載流子壽命和光電導率圖同時測量。在進行晶圓測量時,需要用戶提供樣品的厚度。
l步徑≥1mm
l邊緣:12mm
l電阻率片厚度:150-250µm
l可指定電阻率范圍
l默認設置:0.5-5 Ohm cm
l準確度:< 5%
l重復性:< 1%(范圍從0.5-3 Ohm cm)
為了研究發射極擴散的均勻性,有可能繪制出發射極的方阻。基礎的電阻率由用戶給出。
l方阻測量范圍是0.1-200 Ohm/sq。
l在標準樣本量下的準確度,
l0.1-10 Ohm/sq: < 3 % accuracy
l10-100 Ohm/sq: < 4 % accuracy
l100-200 Ohm/sq: < 5 % accuracy
圖1 - 3顯示了在mc-Si晶圓片和硅塊上測量的電阻率圖。
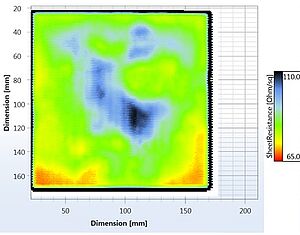
圖1.典型mc-Si晶片的發射極方阻圖,平均方阻值為85.1 Ohm/sq
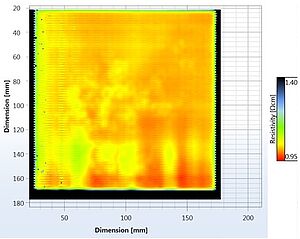
圖2.用于光伏應用的典型mc-Si晶片的電阻率圖,平均電阻率為1.0 Ohm cm
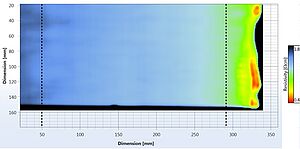
圖3.用于PV應用的典型mc-Si磚的電阻率圖,平均電阻率為1.4 Ohm cm


